光谱椭偏仪 FE-5000 / 5000S
除了可以进行高精度薄膜分析的光谱椭偏仪外,我们还通过实现测量角度的自动可变机构来支持所有类型的薄膜。除了传统的旋转光子探测器方法外,还通过为延迟板提供自动解吸机构提高了测量精度。
包括s波和p波的线偏振光入射到样品上,测量反射光的椭圆偏振光。s波和p波的相位和幅度独立变化,p波和s波反射率的比值tanψ和相位差Δ是两种偏振态视样品而定的转换参数,获得。
tanψ 和 consΔ 称为椭偏参数,光谱椭偏测量这两个参数的波长相关光谱。
* 1 可驱动导流板,可装卸对死区有效的相位差板。
ITO(氧化铟锡)是用于液晶显示器的透明电极材料,由于成膜后的退火处理(热处理),其导电性和颜色得到改善。此时,氧态和结晶度也发生变化,但这种变化可能相对于薄膜的厚度呈阶梯式变化,不能视为具有光学均匀组成的单层薄膜。
如果样品表面有粗糙度,将表面粗糙度建模为“粗糙层”,其中大气(空气)和膜厚材料以 1:1 的比例混合,并分析粗糙度和膜厚。 . 在这里,我们描述了一个测量表面粗糙度为几纳米的 SiN(氮化硅)的例子。
有机EL材料易受氧气和水分的影响,在正常大气下可能会发生改变或损坏。因此,成膜后立即用玻璃密封。以下是在密封时通过玻璃测量薄膜厚度的示例。中间的玻璃和空气层采用非干涉层模型。
材料nk需要通过最小二乘法拟合来分析膜厚值(d)。如果 nk 未知,则将 d 和 nk 都解析为可变参数。然而,在d为100nm以下的超薄膜的情况下,d和nk不能分离,这可能会降低精度并且无法获得准确的d。在这种情况下,测量具有不同d的多个样品,并且假设nk相同,进行同时分析(多点分析)。这使得可以准确地获得nk和d。
栅氧化薄膜、氮化膜
SiO 2、Si x O y、SiN、SiON、SiN x、Al 2 O 3、SiN x O y、poly-Si、ZnSe、BPSG、TiN
的光学常数(波长色散)抵抗
Al x Ga (1-x)作为多层膜、非晶硅
配向膜
DLC(类金刚石碳)、超导用薄膜、磁头用薄膜
TiO2,SiO2,反射防止膜
g-line (436nm), h-line (405nm), i-line (365nm)等各波长的光刻场n、k评估
原 理
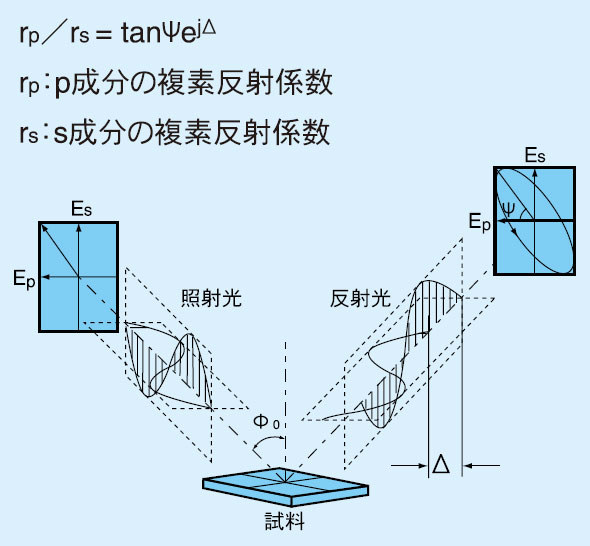
型式
FE-5000S
FE-5000
样本量
最大100x100mm
最大200x200mm
測定方式
旋转光子法*1
测量膜厚范围(nd)
0.1nm~1μm
入射(反射)角范围
45~90°
45~90°
入射(反射)角度駆動方式
自动正弦杆驱动系统
光斑直径*2
φ2.0
φ1.2sup *3
tan ψ 测量精度
±0.01以下
cosΔ测量精度
±0.01以下
可重复的薄膜厚度
0.01%以下*4
波长范围*5
300~800nm
300~800nm
測定用光源
高稳定性氙灯*6
舞台驱动系统
手動
手動/自動
装载机兼容
不可
可
寸法、重量
650(W)×400(D)×593(H)mm
50kg
1300(W)×890(D)×1750(H)mm
350kg *7
* 2 因短轴和角度而异。
* 3 与微小斑点兼容(选项)
* 4 使用 VLSI 标准 SiO2 薄膜(100 nm)时的值。
* 5 这是选择自动阶段时的值。
测量示例
对于这种 ITO,我们将介绍一个使用倾斜模型从上界面和下界面的 nk 测量倾斜度的示例。
![使用倾斜模型的 ITO 结构分析 [FE-0006]](https://www.otsukael.jp/upload/files/FE-5000%E6%B8%AC%E5%AE%9A%E4%BE%8B0006.gif)
![使用倾斜模型的 ITO 结构分析 [FE-0006]](https://www.otsukael.jp/upload/files/FE5_m_02.jpg)
![考虑表面粗糙度的膜厚值测量 [FE-0008]](https://www.otsukael.jp/upload/files/FE-5000%E6%B8%AC%E5%AE%9A%E4%BE%8B0008.gif)
![考虑表面粗糙度的膜厚值测量 [FE-0008]](https://www.otsukael.jp/upload/files/APP8-2.jpg)
![使用非干涉层模型 [FE-0011] 测量密封有机 EL 材料](https://www.otsukael.jp/upload/files/FE-5000%E6%B8%AC%E5%AE%9A%E4%BE%8B0011.gif)
![使用非干涉层模型 [FE-0011] 测量密封有机 EL 材料](https://www.otsukael.jp/upload/files/APP11-2.jpg)
![在多个点使用相同的分析测量 nk 未知超薄膜 [FE-0014]](https://www.otsukael.jp/upload/files/FE-5000%E6%B8%AC%E5%AE%9A%E4%BE%8B0014.gif)
![在多个点使用相同的分析测量 nk 未知超薄膜 [FE-0014]](https://www.otsukael.jp/upload/files/APP14-2.jpg)










