产品详情
简单介绍:
苏州日本大塚光学干涉法膜厚仪FE-300 苏州日本大塚光学干涉法膜厚仪FE-300 苏州日本大塚光学干涉法膜厚仪FE-300
详情介绍:
光干涉膜厚监测仪 FE-300

它是一种紧凑且价格低廉的薄膜厚度计,通过高精度光学干涉法实现薄膜厚度测量,操作简单。
我们采用一体式外壳,将必要的设备容纳在主体中,实现稳定的数据采集。
可以通过以低廉的价格获得绝对反射率来分析光学常数。
制品情报
特 長
- 支持从薄膜到厚膜的各种膜厚
- 使用反射光谱的薄膜厚度分析
- 实现非接触、非破坏的高精度测量,同时紧凑且价格低廉
- 简单的条件设置和测量操作!任何人都可以轻松测量薄膜厚度
- 可以通过峰谷法、频率分析法、非线性最小二乘法、优化法等进行多种薄膜厚度测量。
- 通过非线性最小二乘膜厚分析算法可以进行光学常数分析(n:折射率,k:消光计数)。
測定項目
- 绝对反射率测量
- 膜厚解析(10層)
- 光学定数解析(n:屈折率、k:消衰計数)
测量对象
-
功能膜、塑料
透明导电膜(ITO、银纳米线)、相位差膜、偏光膜、AR膜、PET、PEN、TAC、PP、PC、PE、PVA、粘合剂、粘合剂、保护膜、硬涂层、防指纹, ETC。 -
半导体
化合物半导体、Si、氧化膜、氮化膜、Resist、SiC、GaAs、GaN、InP、InGaAs、SOI、蓝宝石等 -
表面处理
DLC涂层、防锈剂、防雾剂等 -
光学材料
滤光片、AR涂层等 -
FPD
LCD(CF、ITO、LC、PI)、OLED(有机膜、灌封胶)等 -
其他
硬盘驱动器、磁带、建筑材料等。
原理
測定原理
Otsuka Denshi 使用光学干涉仪和我们自己的高精度分光光度计,实现了非接触、无损、高速和高精度的薄膜厚度测量。光学干涉法是一种利用如图 2 所示的分光光度计的光学系统获得的反射率来确定光学膜厚的方法。以涂在金属基材上的薄膜为例,如图1所示,从目标样品上方入射的光被薄膜(R1)表面反射。此外,通过薄膜的光在基板(金属)和薄膜界面(R2)处反射。测量此时由于光程差引起的相移引起的光学干涉现象,并根据得到的反射光谱和折射率计算膜厚的方法称为光学干涉法。分析方法有四种:峰谷法、频率分析法、非线性最小二乘法和优化法。
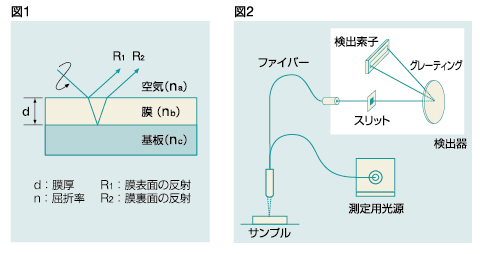
规格
规格
| 测量波长范围 | 300~800nm | |
|
测量膜厚范围 (SiO 2换算) |
3nm~35μm | |
| 光斑直径 | φ1.2mm | |
| 样本量 | φ200×5(H)mm | |
| 測定時間 | 0.1~10s以内 | |
| 電源 | AC100V±10% 300VA | |
| 寸法、重量 | 280(W)×570(D)×350(H)mm、24kg | |
| 其他 | 参考板,配方创建服务 | |
软件画面










